IBM和高通谈对三维LSI技术的期待
来源:日经BP社报道 作者:—— 时间:2013-05-09 10:34
利用基于TSV(硅通孔)层叠芯片的三维LSI技术越来越受期待。在2013年4月于大阪举行的半导体封装技术的国际会议“International Conferenceon Electronics Packaging(ICEP)2013”上,关于半导体芯片代工有三场主题演讲,其中两场的主题都是三维LSI(图1)。

图1:半导体封装技术国际会议“ICEP 2013”
在2013年4月10~12日于大阪国际会议场举行的“ICEP 2013”上,三维LSI技术等相继发表。为促进技术人员之间的交流,会期内还组织参观了大阪城等。
之所以需要三维LSI技术,是因为半导体的微细化(定标,scaling)已经接近极限。IBM研究员、IBM系统科技集团微电子部门的Subramanian S.Iyer在ICEP上发表了主题演讲,他表示“估计现在的晶体管技术至少能够微细化到7nm工艺,但随着蚀刻成本增加,每个晶体管的成本肯定会增加”。
因此,半导体行业应该致力于与原来二维方向(X-Y方向)定标不同的的Z轴向“垂直定标”(Orthogonal Scaling)。重要技术包括层叠微处理器和内存的三维LSI技术,采用深沟道的混载DRAM技术以及采用深沟道的片上去耦电容技术。IBM计划利用上述技术,大幅减小高性能服务器的主板的尺寸(图2)。
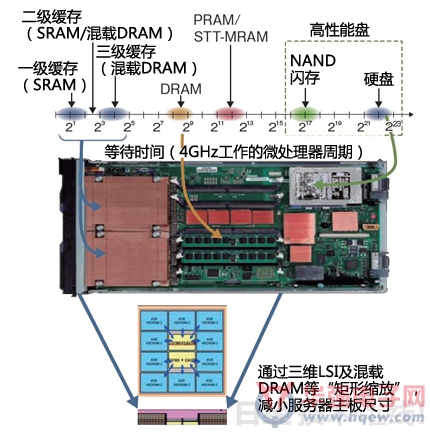
图2:推进主板小型化
IBM计划利用三维LSI技术及混载DRAM技术等不同于以往微细化的“垂直定标”实现主板小型化。
高通计划应用于智能手机
IBM希望利用三维LSI技术减小服务器尺寸、提高服务器性能,而高通则计划将该技术应用于智能手机。将引进利用TSV在移动SoC上层叠Wide I/O DRAM的“TSS(through-silicon stacking)”技术(图3)。
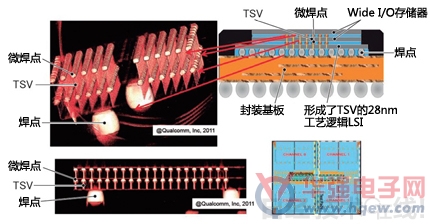
图3:高通正在开发的三维LSI技术
高通正在加快开发在手机SoC上层叠Wide I/O内存的三维LSI技术。
据Gartner预测,全球智能手机出货量到2016年将达到50亿部。如果基于TSV的三维LSI技术被智能手机采用,那么TSV技术将迅速普及。因此,半导体行业一直关注着高通等大企业是否采用TSV技术。在此次的ICEP上发表了主题演讲的高通的工程师兼高级主管Urmi Ray说道:“没有阻碍基于TSV的三维LSI技术实现实用化的根本性问题,技术熟练程度也在迅速提高。”
另一方面,Urmi Ray也表达了对TSV成本的担心。他指出,“目前采用TSV的Wide I/O DRAM和硅转接板的价格很高,该技术要想全面普及,必须进一步降低成本”。他还指出,业界必须要开发采用玻璃的低成本转接板技术等各种新技术。另外,高通计划将该技术应用于平板电脑的移动SoC,同时还考虑引进在硅转接板上集成芯片的2.5维LSI技术。
现在,高通尚未公布将基于TSV的三维/2.5维LSI技术用于量产的时间。与IBM瞄准的高性能服务器用途相比,智能手机用途对TSV技术的低成本化要求更加苛刻。因此,很多人认为TSV技术应用于移动SoC量产“最早要到2015年”(ICEP与会者)。
由上可见,认为TSV技术普及还需要一些时间的人越来越多,也有人认为“如果TSV技术普及得更晚,通过无线方式以低成本进行芯片间通信的技术等将率先量产”。
- •大联大诠鼎集团推出基于Qualcomm产品的Wi-Fi 7家庭网关方案2024-11-12
- •大联大诠鼎集团推出基于Qualcomm产品的Auracast蓝牙广播方案2024-05-16
- •对标高通骁龙8155!这家国产车规芯片厂商出货超20万片2024-03-08
- •击败高通!最新全球芯片设计厂商TOP10排名2023-09-25
- •突发!传高通大裁员!2023-09-21
- •大杀价!传高通降价大甩卖清库存芯片2023-08-14
- •高通宣布将收购车载通信芯片厂商Autotalks2023-05-08
- •扩大采购!高通砸42亿美元大单,涉汽车、5G、WiFi等芯片2022-08-09
- •传诺领科技倒闭,曾立志成中国高通,却止步B轮融资2022-07-28
- •再涨!英特尔、高通之后,博通、TI芯片纷纷跟进逆风涨价!2022-07-21






