倒装芯片与芯片级封装异军突起 市场占有率提升
来源:互联网 作者:------ 时间:2014-07-31 09:56
早在几年前,倒装芯片技术就已经受到业界关注,但由于成本、技术等原因,致使下游终端市场保持沉寂。而随着近几年技术的不断提升,使得倒装芯片成本不断下降,同时市场接受度进一步提升。目前,台湾晶元、新世纪,大陆晶科、华灿、同方半导体、三安、德豪等芯片厂商均有倒装产品推出。
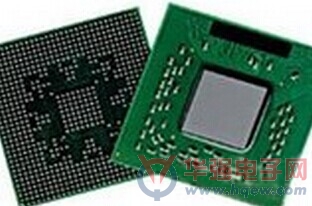
CSA Research认为,倒装芯片具有高可靠性、高光效、散热好、易集成等优点,特别是在大功率器件和集成封装产品上优势明显。但是目前倒装芯片量产的产品还比较少。而且在中小功率的应用上,倒装芯片的成本竞争力还不是很强。
基于倒装芯片,各芯片厂商还推出所谓的“芯片级封装(免封装)产品,其并不是真正省去封装环节,而是将部分封装工序提前到芯片厂完成。就目前来看这类产品还不具有成本优势,市场份额也不大。晶元是较早进入该领域的厂家之一,此外台积固态照明、璨圆、隆达、PhilipsLumileds、CREE也都有类似产品发布,大陆厂商仅有晶科电子有少量量产产品,称之为“芯片级无金线封装”。
部分企业的芯片级封装产品:
●晶电的芯片级封装产品称为ELC(Embedded LED Chip),制程中完成芯片生产后,仅需要涂布荧光粉与采用封装胶,省略导线架与打线的步骤,可以直接贴片(SMT)使用,ELC产品在没有导线架的情况下,发光角度较大,未来可能省略二次光学透镜的使用。
●台积固态照明则的芯片级封装产品名为PoD(Phosphorondie),直接将flipchip(覆晶)芯片打在散热基板上,省略导线架与打线等步骤,同样主打小体积,拥有更高的光通量和更大的发光角度,并且可以更容易混色与调控色温特性,适用于非指向性光源应用。
●璨圆2013年也积极推广其芯片级封装产品,同样以flipchip为基础,在制程中省略导线架与打线等步骤。
●隆达将其芯片级封装CSP(Chip Scale Package)产品在上游晶粒也采用覆晶技术,也同样省略导线架,并简化封装流程。
●Philips Lumileds推出的CSP产品LUXEONQ就采用flipchip技术,不需在后段制程中移除蓝宝石基板。
●CREE的XQ-ELED产品也同样采CSP技术,将芯片面积大幅缩小,其微型化设计可以提升光调色品质与光学控制,扩大照明应用范围。
综合各企业产品,共同的特点是采用倒装芯片,使体积更小,光学、热学性能更好,同时因省略了导线架与打线的步骤,使其后道工序更加便捷。
关注电子行业精彩资讯,关注华强资讯官方微信,精华内容抢鲜读,还有机会获赠全年杂志。
关注方法:添加好友→搜索“华强微电子”→关注
或微信“扫一扫”二维码

- •关键节点落地! 美国芯片关税迈入“第二阶段”2026-04-15
- •中东局势升级:一场正在逼近的全球芯片供应链危机2026-03-24
- •突发!三星9万人准备罢工:全球芯片要变天了?2026-03-18
- •芯片价格全面失控:最高暴涨70%,这一轮半导体周期不一样了2026-03-18
- •2026最硬科技!原子级3D成像揭示芯片内部“鼠咬”缺陷,芯片研发从此不同2026-03-06
- •芯片战再升级!美政府采购禁令来袭,SIA强烈发声反对2026-03-05
- •阿里“造芯”走到关键一步?平头哥或冲击IPO2026-01-26
- •重磅消息!中国对日本进口芯片发起反倾销调查!2026-01-08
- •免费直播预告 | 从理论到实操,全面解析ADC/DAC芯片测试前沿方案!2025-06-17
- •摩尔斯微电子携手Gateworks,利用Wi-Fi HaLow革新工业连接2025-06-04






