三星官宣X-Cube 3D封装技术
在Intel、台积电各自推出自家的3D芯片封装技术之后,三星也宣布新一代3D芯片技术——X-Cube,基于TSV硅穿孔技术,可以将不同芯片搭积木一样堆叠起来,目前已经可以用于7nm及5nm工艺。
关于3D芯片封装,了解半导体芯片技术的玩家应该不陌生了,现有的芯片都是2D平面堆叠的,随着芯片数量的增多,占用的面积越来越大,不利于提高集成度。
3D封装顾名思义,就是将芯片从平面堆叠变成了垂直堆叠,类似搭积木那样一层层叠加,减少了芯片面积,提高了集成度。
台积电、Intel之前都公布了3D封装技术,技术风向大同小异,具体的实现方法不同,Intel的3D封装叫做Foveros,已经在Lakefield芯片上应用,集成了10nm CPU、22nm IO核心。
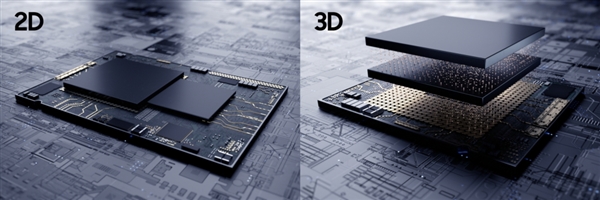
三星自家的3D封装技术叫做X-Cube,基于TSV硅穿孔技术将不同芯片堆叠,已经可以将SRAM芯片堆叠到芯片上方,释放了占用空间,可以堆栈更多内存芯片。
此外,TSV技术还可以大幅缩短芯片之间的信号距离,提高了数据传输速度,降低了功耗,并且客户还可以按需定制内存带宽及密度。
目前三星的X-Cube技术已经可以用于7nm及5nm工艺,三星将继续与全球无经验半导体公司合作,将该技术部署在新一代高性能芯片中。
- •突发!三星9万人准备罢工:全球芯片要变天了?2026-03-18
- •三星涨100%苹果被迫接招!2026-02-28
- •突发!DRAM价格冲击70%,三星和SK海力士联手出击!2026-01-07
- •三星NAND闪存芯片,涨价15~20%2024-03-14
- •三星西安厂开工率恢复2024-03-12
- •三星电子管理层与全国三星电子工会举行谈判2024-02-20
- •传三星晶圆代工一季度将降价5%-15%2024-01-05
- •三星半导体业务大亏13万亿韩元2023-12-27
- •三星Display以2.18亿美元收购美国Micro OLED开发商eMagin2023-05-19
- •三星在日本投资,建设芯片研发产线2023-05-15






