分析:TSMC进入LED的产业冲击
来源:国际电子商情 作者:—— 时间:2010-06-10 08:46
2008年4月台积电(TSMC)透过旗下创投VTAF公司投资美国LED大厂BridgeLux,并取得一席董事,此为台积电进入LED产业开端。 2010年3月25日台积电于新竹科学园区举行LED照明技术研发中心暨量产厂房动土典礼,为跨入绿色能源新事业写下重要里程碑。
此LED厂第一期厂房设施及生产设备的投资额为新台币55亿元,初期放置至少十台MOCVD机台,预计2010年第四季完工装机,并于2011年第一季开始量产;至于第二期工程,则将依据未来的发展需求择期进行。未来台积电将由Epi/Chip至封装一贯生产,并将光、电、热处理整合于硅基板上,以光引擎模块方式出货,提供照明产品所需组件,开辟B2B的企业客户应用市场。
台积电于竹科建LED厂正式宣示跨入LED生产,势必对于台湾LED产业投下不少变量,本文将针对TSMC投入LED产业后可能造成的影响以及未来台湾LED产业可能的变化进行分析。
影响分析
(一) 垂直整合,提高产业资金及市场进入障碍
台湾LED产业发展至今已有30年历史,过去产业一直以专业分工为主,晶电、璨圆、泰谷、广镓等专注于磊晶及晶粒制造,亿光、光宝、东贝等厂商专注于LED封装制造,直到近2~3年奇力、隆达以及台积电相继投入之后才逐渐打破专业分工的产业结构,更在台积电投入之后开始规划生产制造LED模块,将电、光、热同时解决,以利于下游厂商应用。
在奇力、隆达以及台积电投入之后,台湾LED产业开始走向垂直整合,若垂直整合经营模式可以成功,未来将会使得LED产业进入门槛提高,其中包括资金及市场。资金方面,由于垂直分工使得厂商若选择进入其中一端,所需资金相对于垂直整合少,因此未来新进入者在资金门槛上将大幅提高,也将使得台湾LED产业持续迈向大者恒大的局面。
市场部分,垂直整合后将会使得过去仅作磊晶/晶粒或封装厂商无法进入供应体系,举例而言,过去上游厂商仅提供晶粒因此主要客户都是下游封装厂,但若台积电自行垂直整合,势必不会在跟上游磊晶/晶粒厂购买Chip,因此大幅提高市场进入障碍。
此外,透过垂直整合可以使责任厘清更加明确及有助于技术提升。垂直整合后将可以解决过去因专业分工所造成的问题,专业分工时,若LED出现问题则较无法厘清责任归属,垂直整合后,由于皆属厂商内部制造,由上游磊晶、晶粒及封装都属该家公司负责生产,使得产品品质控制及责任归属上将更加明确。另外垂直整合后对于技术提升上也将有相当大的助益,举例而言,若某种萤光粉需要搭配特殊规格的蓝光芯片,才能达到最好的发光效率,但碍于过去专业分工,将使得磊晶厂未必愿意制造特殊规格蓝光芯片,但垂直整合后,因磊晶、晶粒及封装都一贯生产,内部势必可以支持特殊规格产品,以追求更好的发光效率。

LED产业链变化
(二) 改变技术特性 由工艺型转为标准化制程(技术导向转管理导向)
LED产业在过去一直被定位为工艺型产业,需藉由工程师设备经验,将机台调整至最佳状态,但由于每位工程师经验不同,使得LED制造过程中一直无法大幅提高规格良率。
此外,台湾LED产业多属中小企业,因此设备投资上无法像大型公司有足够资金支持,因此在自动化生产设备投资会受限于资金不足,无法快速导入标准化/自动化生产。且过去台湾LED产业面临与半导体、TFT产业竞争人才,多数优秀人才选择前景看好之半导体厂及TFT厂,使得LED产业在制程管理上不若半导体产业好。
在台积电投入LED产业后,势必会将台积电在半导体有效率的管理制程导入LED产业中,并将制程朝向标准化及自动化生产,降低人为因素的干扰;以台积电目前规模,资金实力雄厚,若此举可以成功的话,将会使得台湾LED产业由过去工艺型产业,朝向标准化/自动化生产,一举解决LED规格良率问题,将有机会使LED规格良率大幅提升。
若LED规格良率真可以大幅提高,有效产能将会大幅提高,将使得LED价格得以持续下滑,对于应用市场推广将有相当大帮助。若台积电真能大幅提高有效产能,既有厂商竞争力将也可能转变,若既有厂商无法跟着提高有效产能,将使得竞争力下滑;且由于目前规格品良率不高,使得厂商只能藉由扩充厂能来生产所需产品,因此若规格品良率真能大幅提高,是否意谓着以目前产能状况可能足以供给市场需求,未来是否还需要持续扩厂,值得大家注意。
(三) 发展硅封装基板
台积电在未盖厂之前已有转投资采钰科技从事LED硅基板封装技术的开发,日前采钰科技发表8吋晶圆级LED硅基封装技术,被业界视为高功率LED封装的新突破;采钰的8吋晶圆级LED硅基封装技术,是运用专利的微型化半导体微机电制程,透过硅晶穿孔、铸模透镜以及均匀萤光材料涂布等独家技术,整片封装再进行切割,可大量生产并降低成本;在单晶LED封装产品热阻可望降至2℃/W,并大幅降低接口温度(junction temperature < 50℃ at Ta=25℃)。
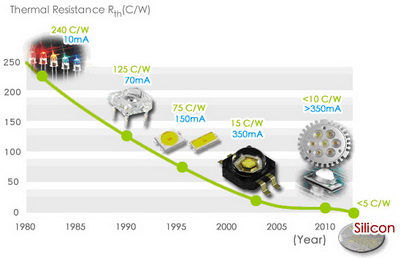
Si散热能力评估
传统LED结构的封装方式,芯片散热往往被低热传系数的蓝宝石基板所局限。蓝宝石基板的热传系数只有40 W/mK,而且蓝宝石基板的厚度通常在数十微米左右,更增加整体热传的困难度,因此传统的芯片键合结构并不是一个效率好的散热设计。目前覆晶式的芯片封装很吸引人们的目光,因为能提供一个较好的散热系统,主动发光层产生的热可由下方大面积的焊料凸块向外传导,进而提高LED发光的效率。
(四) LED光引擎(Light Engine)发展,降低组件至系统端的沟通成本,加速LED照明发展
台积电欲发展的硅基板除热传导系数佳,热传导系数可达80~150W/mK之外,也可以将电路也整合进去,形成LED光引擎模块,使得下游应用厂商在使用上将更加便利统,对于未来下游LED照明应用扩展有相当大帮助,有机会加速LED照明应用发展。
- •2017年全球光刻机出货294台,ASML接近7成2018-05-04
- •苹果A11芯片或采用10nm制程生产2017-04-19
- •Synopsys的IC Compiler II通过了TSMC7nm制程工艺认证2017-04-07
- •Synopsys的IC Compiler II通过TSMC12nm制程工艺认证2017-04-07
- •优化TSMC InFO封装技术 Cadence推出全面整合设计流程2017-04-01
- •TSMC代工Mac芯片将比代工A系列更赚钱?2016-11-16
- •ARM:针对台积电推出POP IP2016-06-15
- •Arasan推出支持TSMC 28纳米HPC工艺的DPHY IP核2016-06-01
- •Xilinx宣布与TSMC开展7nm工艺合作2015-05-29
- •TSMC量产20nm芯片或取代三星获A8订单2013-12-16






