2.5D堆叠硅片引领FPGA产业跨入新时代
来源:华强电子网 作者:梅丹 时间:2011-11-01 13:59
3D IC技术商用面临三大挑战 2.5D IC堆叠技术引领潮流
3D IC在半导体业界已经不算稀奇,一年前,赛灵思就与业界分享过3D IC的技术,但为什么现在变成了2.5D堆叠封装?2.5D 堆叠技术会成为3D中间的过渡技术吗?赛灵思又是如何看待3D IC堆叠技术的发展前景?对此,汤立人一一作了解释。
2.5D是指在无源器件上堆叠有源芯片,而3D IC是指在有源芯片上堆叠有源芯片。汤立人表示,目前做3D主要面临诸多挑战,其中有三个是当前的主要难点。首先,3D是垂直的堆叠,把两个主动IC用微 凸块(micropum)连在一起,微凸块是一种新兴技术,中间有非常多的挑战,两个硅片之间有应力。举例来说,两个芯片本身的膨胀系数有可能不一样,中 间连接的微凸块受到的压力就很大,一个膨胀快,一个膨胀慢,应力就比较大。第二,硅通孔(TSV)也有应力存在,会影响周围晶体管的性能。第三,热管理, 如果两个都是主动的IC,散热就成为很大的问题。所以对于3D,这三个问题是整个行业需要解决的。
“2.5D的硅中介层是被动的,中间没有晶体管,不存在TSV应力以及散热问题,所以可以代替3D的技术。但是,不是所有公司都可以用到这个技术,如果中间连线太长,就需要晶体管。赛灵思有一个架构,可以非常容易地应用2.5D。” 汤立人解释道。
对于架构,赛灵思亚太区销售及市场总监张宇清进一步补充道:“赛灵思架构是Column Base,每个Column之间可以连接在一起,四个之间连接起来,走线是最短的。如果不是这种架构,很难做到。Colunm架构,加减模块比较方便。”
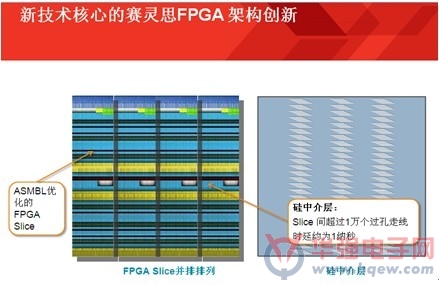
2.5D是否会成为过渡技术也是业界都比较关注的问题。对此,汤立人称,2.5D会一直走下去,2.5D有自己的应用,不一定被3D所代替。“无论是在EDA还是Fab,都在思考3D,我们同样看好不带中介层的完全 3D IC 堆叠技术的前景,也在与合作伙伴研发3D,但当前整个行业都在推2.5D,3D还在研发中,3D真正量产还需要两三年的时间。”
汤立人表示:“2.5D上面所有晶片都是同构的,将来2.5D可以做到异构。这意味着利用堆叠技术可以把不同类型的器件集成进去。”毫无疑问,这又将是一项重大的突破。(责编:王琼芳)
下一篇:IC领域尚需形成专利群体保护规模
相关文章
- •瑞萨公开下一代车用SoC和MCU处理器产品路线图2023-11-08
- •思特威AI系列再添三款全性能升级图像传感器新品2023-10-25
- •首秀中国大陆,领军者SiFive携全线产品和生态伙伴掀起 RISC-V热潮2023-07-10
- •艾迈斯欧司朗发布最新园艺照明技术消息:OSLON Optimal植物照明LED系列新增增强型640nm Red(红光)产品2023-06-15
- •最新中国集成电路IC产品进出口表现2023-06-12
- •IGBT需求大增背后:客户疯狂抢货 产品价格涨翻天2023-03-29
- •累计出货数亿颗!这家厂商车规RTC产品市占率突破20%2022-12-02
- •这 5 款苹果新品将至:购买者再等等 2022 款 iPad Pro、iPad 10、M2 Pro / Max 版 MacBook Pro...2022-10-09
- •消息称英特尔计划 Q4 涨价,主板芯片组产品全线拉涨约 10%2022-09-07
- •二季度全球半导体产品销售额同比增长13.3%2022-08-02






